X射线荧光(XRF)是一种非破坏性技术,用于量化材料的元素组成并测量薄膜厚度和成分。 X射线用于激发样品,导致X射线的发射具有存在的元素的特征能量。
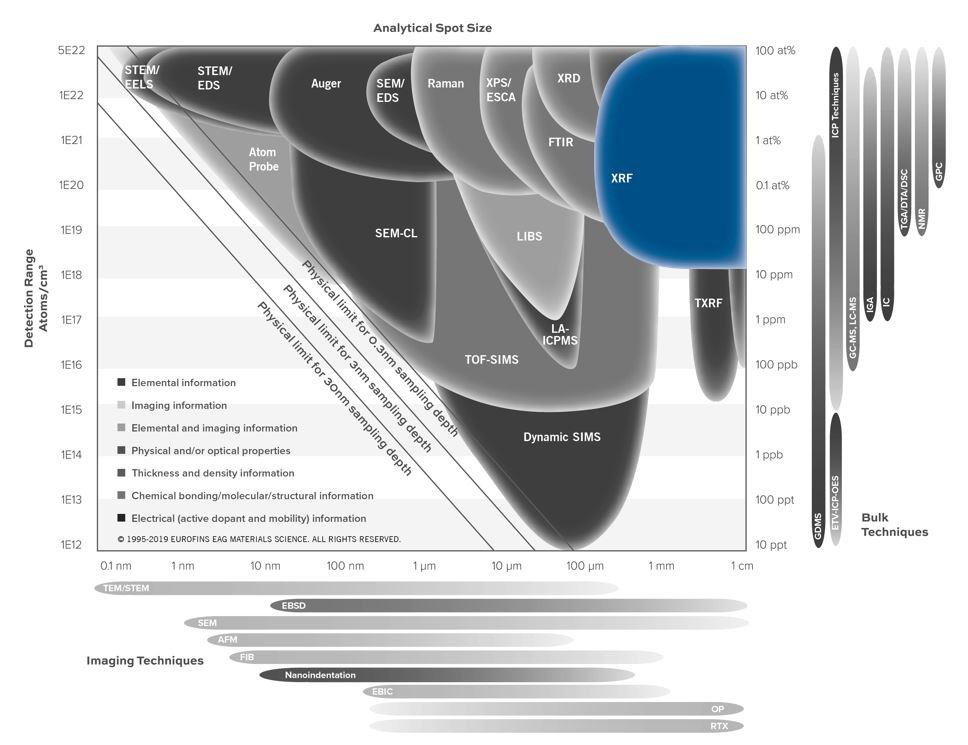 XRF是智能图表并测量散装材料和薄膜的成分和杂质。
XRF是智能图表并测量散装材料和薄膜的成分和杂质。
XRF能够检测 BU 中浓度从 ppm 到 100% 的元素。 此外,使用该技术可以测量铜。 由于使用 X 射线来激发样品,因此可以实现从小于一纳米到几毫米的分析深度,具体取决于材料。通过使用适当的参考标准或在标准不可用时使用基本参数 (FP),XRF 可以准确量化元素组成大多数材料。
有五个 XRF 系统可用:四个波长色散仪 (WDXRF) 和能量色散仪 (EDXRF), 主要区别在于分离和测量 X 射线的方式。 WDXRF具有非常好的能量分辨率,可减少光谱重叠并改善背景强度。 EDXRF具有更高的信号吞吐量,可实现小区域分析或映射。
理想用途
- 首先,测量从埃到几微米的薄膜厚度和成分
- 其次,用于大多数材料的一般元素鉴定和定量,包括玻璃,金属,陶瓷,聚合物或残留物
- 第三,用于识别特定的金属合金或玻璃类型
- 第四,用于痕量分析固体或液体样品中的污染物
- 第五,在鉴定和定量聚合物中的无机填料时
- 另外,对于大型溅射靶材的无损分析
- 最后,用于无损分析直径最大为300 mm的晶片上的薄膜
优势强项
- 非破坏性
- 整个晶片分析(最大300毫米)以及晶片碎片和小样品
- 超大样品的 EDXRF 分析:15x15x10 cm (LxWxH)
- 对非常大的样本进行WDXRF分析:直径400毫米,厚度50毫米,质量30千克
- 多层薄膜叠层的厚度和组成
- 可以分析小至〜30 µm(EDXRF)或500 µm(WDXRF)的区域
- 可以分析任何固体材料和一些液体
- 采样深度从小于1纳米到几毫米不等,具体取决于材料
缺点限制
- 首先,它无法使用EDXRF检测比Na更轻的元素
- 其次,它无法使用WDXRF检测比B轻的元素(可以检测到Be,但只能在铜中检测到)
- 第三,最高精度的测量需要在成分和/或厚度上与测试样品相似的参考标准
技术规格
- 检测到信号: X射线
- 检测到的元素: BU(WDXRF); Na-U(EDXRF)
- 检测限: 1 ppm –大多数元素为100 ppm
- 成像/制图: 是(最大6×10厘米面积)
- 横向分辨率/探头尺寸: 500μm,1mm,6mm,10mm,20mm,26mm,30mm或37mm(WDXRF); 30 µm,1 mm,2 mm(EDXRF)
您也可以致电400-9621-929与我们联系或填写下方表格,让专家工程师和您讨论具体的需求。
在线和工程师讨论需求
上一篇
X射线衍射(XRD)下一篇
X射线反射率(XRR)



 请专家与您联系
请专家与您联系 微信号:13152181175
微信号:13152181175